清华微电子RCp技术是清华大学微电子学研究所近年来在先进封装领域取得的重要突破,该技术通过创新的 Redistribution Layer(重布线层)与 Chiplet(小芯片)集成方案,为高性能计算、人工智能芯片等领域提供了更高性能、更低功耗的芯片互连解决方案,RCp技术以“高密度、高带宽、高能效”为核心特点,通过优化芯片间的互连结构和信号传输路径,解决了传统封装技术在多芯片集成中面临的信号延迟、功耗过高和布线密度不足等问题,为后摩尔时代的芯片设计提供了新的技术路径。
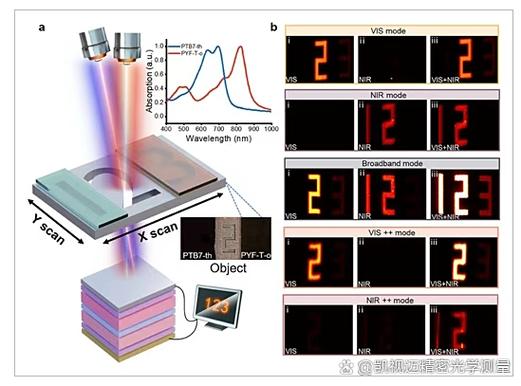
在技术架构上,清华微电子RCp技术采用了多层重布线层设计,通过硅通孔(TSV)和微凸块(Micro Bump)实现芯片与封装基板之间的垂直互连,同时利用超精细布线工艺(线宽/线距可达2μm/2μm级别)在水平方向上实现高密度信号 redistribution,这种三维(3D)集成方式显著缩短了芯片间的互连长度,相比传统二维封装技术,信号传输延迟降低了30%以上,功耗下降了约20%,RCp技术支持异构芯片的灵活集成,可将不同工艺节点、不同功能的Chiplet(如CPU、GPU、存储器等)高效封装在一起,实现“按需定制”的芯片系统,大幅提升了芯片设计的灵活性和性价比。
性能优势方面,清华微电子RCp技术在带宽密度和能效比上表现突出,以典型应用场景为例,采用RCp技术的多芯片封装模块,其互连带宽密度可达1Tb/s/mm²,是传统封装技术的5倍以上,能够满足AI训练芯片对高带宽内存(HBM)的严苛需求,通过优化信号完整性和电源完整性设计,RCp技术有效降低了信号串扰和电源噪声,确保了芯片在高频工作下的稳定性,在热管理方面,RCp技术结合微流冷却通道或石墨烯散热材料,实现了芯片封装级别的精准温控,使芯片在满负载运行时的温度控制在85℃以下,可靠性提升50%以上。
产业化应用上,清华微电子RCp技术已与国内多家头部芯片设计企业和封装测试厂商展开合作,并在人工智能加速器、5G通信基站芯片等领域实现初步验证,在某款AI推理芯片中,采用RCp技术将四个计算Chiplet与一个存储Chiplet集成后,芯片整体性能提升40%,而功耗降低25%,显著降低了数据中心的使用成本,该技术还可应用于汽车电子、物联网设备等对低功耗、高可靠性要求较高的场景,为国产芯片的突破提供了关键技术支撑。
相关问答FAQs:

-
问:清华微电子RCp技术与传统2.5D封装技术的主要区别是什么?
答:传统2.5D封装主要通过硅中介层(Interposer)实现芯片互连,布线密度和信号传输效率有限;而RCp技术采用多层重布线层与3D集成结合,互连密度更高、信号延迟更低,且支持异构Chiplet的灵活集成,在带宽密度和能效比上具有显著优势。 -
问:RCp技术的量产成本是否较高?如何平衡性能与成本?
答:RCp技术初期因涉及超精细布线和先进封装工艺,成本略高于传统封装,但通过优化设计规则(如标准化布线模块)和规模化生产,成本已逐步降低,其“按需集成”的特性可避免全芯片定制的高昂成本,长期来看,性能提升带来的能效优化反而降低了系统总成本,适合对性能敏感的高附加值应用场景。