随着半导体工艺节点不断向7nm、5nm及以下先进制程迈进,芯片内部的互连技术成为决定芯片性能、功耗和可靠性的关键因素之一,在Intel的芯片制造技术体系中,铜互连技术作为连接晶体管、实现信号传输和电力分配的核心技术,经历了多次迭代升级,为高性能计算和人工智能等领域的突破提供了坚实基础。
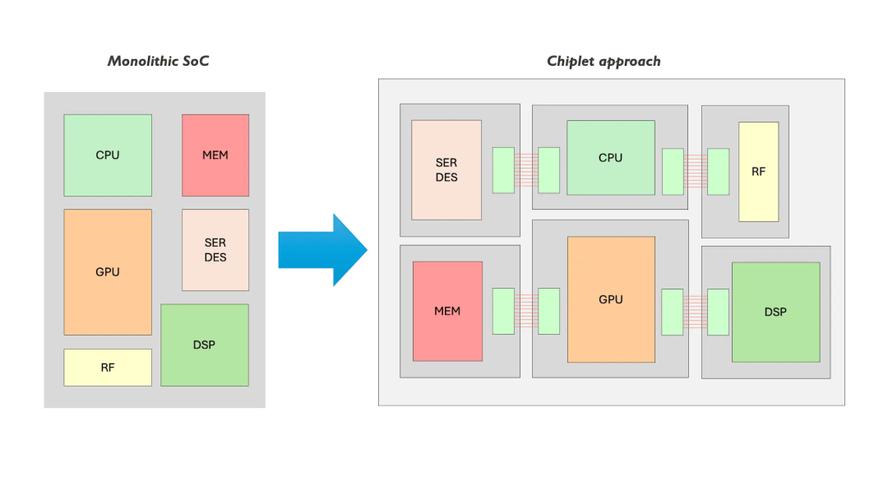
铜互连技术的核心优势在于其低电阻率和高电流承载能力,相较于早期铝互连技术,铜的电阻率降低约40%,能有效降低信号传输延迟和功耗,同时支持更高的集成密度,Intel在90nm工艺节点首次引入铜互连技术时,便通过双镶嵌(Dual Damascene)工艺解决了铜难于刻蚀和易污染的问题,该工艺通过先刻蚀沟槽再沉积铜的方式,实现了铜互连线和通孔(Via)的一体化成型,大幅提升了互连结构的可靠性和良率,随着工艺节点微缩,互连线的RC(电阻-电容)延迟成为限制芯片频率提升的主要瓶颈,为此Intel在65nm节点引入了低k介质材料,通过降低互连线间的介质常数来减小电容,进一步优化信号传输性能。
进入22nm及14nm FinFET时代,互连技术面临更严峻的挑战:互连线条宽缩小至数十纳米级别,铜的电子迁移效应加剧,易导致互连线失效;多层互连堆叠带来的应力效应也影响晶体管性能,针对这些问题,Intel开发了创新的钴(Co)阻挡层/衬里技术,用钴替代传统的钽(Ta)阻挡层,不仅降低了接触电阻,还提高了互连结构的抗电迁移能力,Intel还引入了“自对准多重图案化”(SADP)技术,通过光刻和刻蚀的组合工艺实现更精细的互连线条间距,突破了传统光刻设备的分辨率限制。
在10nm及以下先进制程中,Intel进一步优化了铜互连的层级结构,采用“混合键合”(Hybrid Bonding)技术实现更高密度的互连连接,支持三维堆叠芯片的高带宽数据传输,在Intel的Foveros 3D封装技术中,铜互连层通过微米级的凸点(Bump)实现芯片间的垂直互连,带宽提升高达10倍,同时降低了功耗,Intel还在7nm节点引入了“选择性镶嵌”(Selective Electroplating)工艺,通过精确控制铜的沉积位置,减少互连缺陷,进一步提升良率和可靠性。
为了应对AI和高性能计算对更高带宽和更低延迟的需求,Intel正在研究下一代互连技术,包括“光互连”和“碳纳米管互连”,光互连利用光信号替代电信号传输,有望彻底解决RC延迟问题;而碳纳米管互连凭借其优异的导电性和机械强度,可能成为后摩尔时代互连技术的备选方案,Intel已通过实验室验证了碳纳米管互连在10nm节点的可行性,其电阻率低于铜,且抗电迁移能力提升数倍。

以下是Intel铜互连技术关键演进节点的对比:
| 工艺节点 | 关键技术突破 | 性能提升 |
|---|---|---|
| 90nm | 首次引入双镶嵌铜互连 | 电阻率降低40% |
| 65nm | 低k介质材料应用 | 电容降低20%,延迟降低15% |
| 22nm/14nm | 钴阻挡层/SADP技术 | 抗电迁移能力提升3倍,线条间距缩小35% |
| 10nm | 混合键合/选择性镶嵌 | 3D互连带宽提升10倍,良率提升25% |
| 7nm及以下 | 碳纳米管互连研发 | 电阻率降低30%,抗电迁移能力提升5倍(实验室阶段) |
相关问答FAQs
Q1:铜互连技术相比铝互连有哪些核心优势?
A1:铜互连的核心优势在于低电阻率(比铝低约40%),能显著降低信号传输延迟和功耗;铜的高电流承载能力支持更高集成密度的芯片设计,铜的抗电迁移能力优于铝,可延长芯片使用寿命,通过双镶嵌等工艺,铜互连还实现了更精细的线条结构,满足先进制程的微缩需求。
Q2:Intel在铜互连技术中如何解决电迁移问题?
A2:Intel通过多重技术手段解决电迁移问题:一是采用钴(Co)阻挡层替代传统钽(Ta),降低界面电阻并增强铜原子稳定性;二是优化互连结构设计,如增加线条宽度和厚度比例;三是引入“应力工程”技术,通过 surrounding介质材料调节铜晶格结构,抑制原子迁移,在7nm及以下节点,还探索了碳纳米管等新材料,从根本上提升抗电迁移能力。